

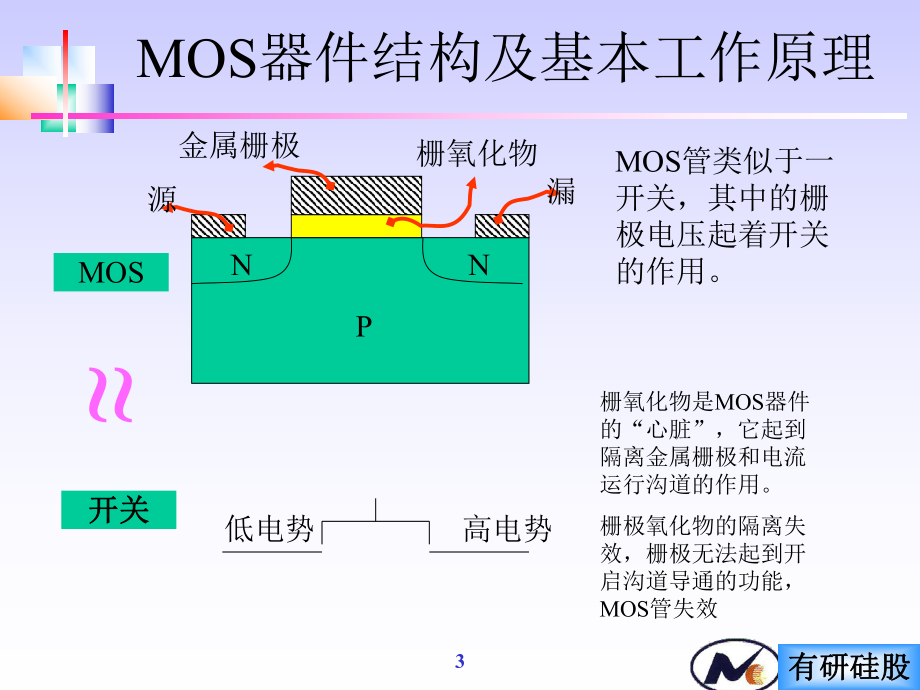


版權(quán)說明:本文檔由用戶提供并上傳,收益歸屬內(nèi)容提供方,若內(nèi)容存在侵權(quán),請(qǐng)進(jìn)行舉報(bào)或認(rèn)領(lǐng)
文檔簡介
1、器件GOI及其失效原因分析肖清華有研半導(dǎo)體材料股份有限公司TelGOI and the degradation-induced factors有研硅股有研硅股2主要內(nèi)容 MOS管結(jié)構(gòu)及GOI定義 GOI失效緣由 GOI的評(píng)估 GOI的應(yīng)變策略 未來的挑戰(zhàn)有研硅股有研硅股3MOS器件結(jié)構(gòu)及基本工作原理PNNMOS開關(guān)開關(guān)柵氧化物金屬柵極低電勢高電勢柵氧化物是MOS器件的“心臟”,它起到隔離金屬柵極和電流運(yùn)行溝道的作用。柵極氧化物的隔離失效,柵極無法起到開啟溝道導(dǎo)通的功能,MOS管失效 MOS管類似于一開關(guān),其中的柵極電壓起著開關(guān)的作用。源漏有研硅股有研硅股4GOI的定
2、義全稱Gate Oxide Integrity,即柵氧化物完整性。它主要表明柵氧化物電學(xué)上“完整”。MOS器件失效的重要原因是柵氧化物的擊穿。一定程度上而言,MOS器件可靠性的同義詞就是GOI。為了提高器件的速度,增大器件電流,降低閾值電壓,柵氧化層厚度需要不斷降低。柵氧化層越薄,對(duì)其品質(zhì)要求就越嚴(yán)格,成功的柵氧化層必須具有很低的漏電流或很高的崩潰電場。有研硅股有研硅股5GOI失效的緣由理想MOS結(jié)構(gòu)的柵氧化物是一絕緣材料,類似于平板電容器,橫跨氧化物的電場可以表示為:EVg/dVg為柵電壓,d為平板間距離,即氧化物厚度當(dāng)柵氧化物變薄的時(shí)候,對(duì)于某一固定的工作電壓(5V,現(xiàn)在多為3.3V),其
3、電場強(qiáng)度就增加了。或者,柵氧化物中存在缺陷,局部電場變化。如此一來,電子就可以tunneling產(chǎn)生漏電流或?qū)е卤罎ⅰ叛趸镏械碾妶龇植加醒泄韫捎醒泄韫?GOI失效的緣由金屬極Si襯底通過Fowler-Nordheim隧穿機(jī)制或熱激發(fā),電子由金屬極直接進(jìn)入氧化物的導(dǎo)帶他們在電場中得到能量,加速運(yùn)動(dòng),并與氧化物晶格膨脹給出能量損失的能量導(dǎo)致:界面處Si-O鍵斷裂,懸掛鍵在帶隙中引入能級(jí),可以俘獲電子和空穴引起鈍化界面陷阱的H的釋放;導(dǎo)致界面處發(fā)生碰撞電離,產(chǎn)生更多的熱電子和熱空穴,空穴再穿越到氧化物中,發(fā)生類似于電子的行為載流子在氧化中的穿越有研硅股有研硅股7GOI失效的緣由雖然SiO2這種介
4、電材料是絕緣體,其中一般不發(fā)生導(dǎo)電。然而一定條件下,該介電材料會(huì)發(fā)生擊穿,導(dǎo)通電流。擊穿類型可以分為本征擊穿和非本征擊穿。電擊穿電擊穿:電子在柵氧化物中橫跨電場作用下加速運(yùn)動(dòng),與材料晶格碰撞。一般而言,柵氧化物的晶格有足夠的能力容納來自電子碰撞產(chǎn)生的能量。但是,在足夠大的電場下,存在于柵氧化物中的電子可以獲得較大的動(dòng)能,引起晶格原子的電離,導(dǎo)致雪崩效應(yīng),材料中產(chǎn)生顯著的電流。本征擊穿的機(jī)理有熱擊穿、電擊穿和熱電混合擊穿。熱擊穿熱擊穿:SiO2中有顯著的電流通過時(shí),焦耳熱使材料溫度升高,反過來又促使電流增大,如此循環(huán)下去,在很短時(shí)間內(nèi)SiO2發(fā)生局部或全部熔化、分解或揮發(fā)而損毀。材料熱導(dǎo)率、環(huán)境
5、溫度、散熱條件和電場的持續(xù)時(shí)間都會(huì)影響熱擊穿電場數(shù)值。柵氧化物的擊穿機(jī)理有研硅股有研硅股8GOI失效的緣由柵氧化物的擊穿機(jī)理非本征擊穿:是由于SiO2中的針孔、微裂縫、纖維絲、雜質(zhì)等引起的,是SiO2膜中薄弱環(huán)節(jié)處的擊穿,不能反應(yīng)SiO2膜本身的固有特征。有研硅股有研硅股9GOI失效的緣由之:Na+Na+ Na+SiO2SiOxSiSiO2中的可動(dòng)離子電荷固定氧化物電荷界面陷阱電荷氧化物陷阱電荷SiO2層外表面的正負(fù)離子可動(dòng)離子電荷:主要是Na、K、H等正離子,它們在激活后將移向Si-SiO2界面附近,并在Si表面感應(yīng)出負(fù)電荷,使MOS器件的閾值電壓不穩(wěn)定,還會(huì)降低SiO2的介電強(qiáng)度,導(dǎo)致Si
6、O2的過早擊穿。Al固定氧化物電荷:來源是界面附加過剩硅離子,帶正電,不受SiO2厚度、Si中摻雜程度以及界面能帶彎曲和電勢變化的影響。(111)(110)(100)。氧化溫度高、氧化速率低、干氧化有利于這部分電荷的減少。界面陷阱電荷:來源是Si和SiO2界面的不連續(xù),導(dǎo)致界面處Si的懸掛鍵存在,它們在禁帶中呈一些分離的或連續(xù)的能級(jí)或電子狀態(tài)。半導(dǎo)體表面處的晶格缺陷、機(jī)械損傷和雜質(zhì)污染都可以使界面陷阱電荷密度增加。它們會(huì)增加MOS管的閾值電壓,降低表面溝道載流子遷移率和跨導(dǎo),引起器件性能不穩(wěn)定。該類電荷與襯底晶向有關(guān),(111)(110)(100)。氧化物陷阱電荷:來源是電離輻射、雪崩注入或其
7、它類似過程注入到SiO2中的空穴或電子。他是MOS管負(fù)偏壓不穩(wěn)定的原因之一,甚至?xí)褂行系篱L度發(fā)生變化。外表面正負(fù)離子:來源于制造過程中的沾污,主要是影響電極引線漏電。Si-SiO2系統(tǒng)中的電荷有研硅股有研硅股10GOI失效的緣由之: 顆粒顆粒Vgdparticle硅片表面異質(zhì)顆粒是柵氧化物中針孔缺陷形成的重要原因之一,因?yàn)樗梢詫?dǎo)致柵氧化物減薄,甚至穿透氧化物。電力線在顆粒處匯集,導(dǎo)致此處電場顯著增大,進(jìn)而引發(fā)器件擊穿。有研硅股有研硅股11GOI失效的原因之:COP什么是COP?有研硅股有研硅股12GOI失效的原因之:COP氧化物生長過程中,垂直襯底面向的方向比垂直V型槽壁的方向生長快。因
8、此,COP導(dǎo)致其內(nèi)壁及其邊緣氧化物厚度變薄,電場在此聚集,容易擊穿。COP對(duì)GOI的影響還取決于柵氧化物厚度,該厚度在40-50nm時(shí),影響最大,而當(dāng)厚度減至5nm左右時(shí),COP的影響甚微。有研硅股有研硅股13GOI失效的緣由之:氧沉淀氧沉淀氧沉淀的影響在于誘發(fā)位錯(cuò)和層錯(cuò)等二次缺陷,增加漏電流有研硅股有研硅股14GOI失效的緣由之:金屬雜質(zhì)金屬雜質(zhì)2003 ITRS指定Ca、Ba、Sr和Fe為GOI killer,它們的表面金屬量不應(yīng)大于5E9Fe雜質(zhì)影響GOI的原因在于Fe金屬擴(kuò)散到SiO2/Si界面形成沉淀,并可能刺入氧化物中。這導(dǎo)致氧化物變薄,在沉淀尖端處電場增大。Fe在氧化物中還可形成
9、與Fe有關(guān)的陷阱,或者分解氧化物,或者形成金屬硅酸鹽Cu污染比Ni對(duì)GOI的影響更大。有研硅股有研硅股15GOI失效的緣由之:有機(jī)物有機(jī)物有機(jī)物影響GOI的原因在于:有機(jī)物對(duì)所覆蓋區(qū)域起到掩蔽的作用,導(dǎo)致沉淀柵氧化物之前的原生氧化物去除不徹底,最終導(dǎo)致柵氧化物的不均勻有機(jī)物熱分解后容易與Si反應(yīng)形成SiC沉淀,進(jìn)而導(dǎo)致柵氧化物的局部變薄,易成為電場匯聚點(diǎn),導(dǎo)致?lián)舸┯醒泄韫捎醒泄韫?6影響GOI的因素之:表面形貌表面形貌硅片表面形貌依據(jù)橫向空間波長可以分為:平整度、納米形貌和表面微粗糙度。空間波長空間波長起起伏伏幅幅度度2nm100m200m20mm20mm200mm微粗糙度微粗糙度平整度平整度
10、納米形貌納米形貌0.1nm1nmN100nmN1nm0.1m10m有研硅股有研硅股17影響GOI的因素之:表面形貌表面形貌平整度對(duì)光刻精確度有顯著影響,但對(duì)GOI并未有特別直接的影響有研硅股有研硅股18影響GOI的因素之:表面形貌表面形貌ITRS2003 revision版認(rèn)為,正表面納米形貌是最重要的形貌參數(shù),它對(duì)器件的影響是兩方面的。一個(gè)是光刻尺寸不均一,另一個(gè)是CMP工藝不均一。雙面拋光DSP可以比單面拋光SSP得到更好的平整度和納米形貌。有研硅股有研硅股19影響GOI的因素之:表面形貌表面形貌粗糙度一般認(rèn)為粗糙度對(duì)GOI的影響不明顯,也有研究表明,雖然rms值對(duì)GOI沒有顯著影響,但最
11、大P-V值與GOI損失有一定關(guān)聯(lián)。有研硅股有研硅股20GOI失效模式A模式:擊穿發(fā)生在電場范圍0-3MV/cm。這是瞬間失效,一般歸因于針孔缺陷或重金屬污染。B模式:擊穿發(fā)生在3-8MV/cm范圍,主要?dú)w因于COP。表面呈V型槽的COP導(dǎo)致槽內(nèi)和邊緣氧化物薄于正表面的。C模式:擊穿發(fā)生在8-11MV/cm。初始材料表面附近氧沉淀是原因之一。超過11MV/cm才擊穿,氧化物可以說是理想的。有研硅股有研硅股21GOI的評(píng)估驗(yàn)證柵氧化物可靠性的常見方法:Ebd(Electric field-to-breakdown):這是常使用的方法,給氧化物加上恒定或不斷增加的電壓,并測定電場,當(dāng)電場超過一定值時(shí)
12、發(fā)生擊穿。柵極電壓偏移(gate voltage shift,VG):加一定電流到試片,量測柵極電壓的變化量, VG= VG VG0 崩潰電荷Qbd(Charge-to-breakdown): 將電壓加到MOS結(jié)構(gòu)上,促使一可控制電流通過氧化物,即注入一定量電荷進(jìn)入氧化物,直到它失效。電流密度J*時(shí)間JBDThe time-dependent dielectric breakdown(TDDB),這是判斷氧化物介電質(zhì)量的最有用也是最主要的方法。TDDB測量主要有四種不同的方式:Constant voltage(CVTDDB), Constant Current (CCTDDB), ramped
13、 voltage(SVTDDB, or V-Ramp)以及ramped Current(SCTDDB or J-Ramp)。加電壓或電流到試片,量測其崩潰所需的時(shí)間。常常需要利用外插法來預(yù)測其壽命長短。TZDB(Time zero dielectric breakdown): 給試片的柵氧化物加上階梯電壓,直到漏電流大于某一數(shù)值或有一跳躍電流(稱為硬擊穿)。有研硅股有研硅股22GOI的評(píng)估有研硅股有研硅股23GOI的評(píng)估Note: 對(duì)越來越薄的氧化物厚度,氧化物中陷阱密度減小,測試結(jié)構(gòu)面積、所加電壓/電流、極性等對(duì)得到的QBD等數(shù)據(jù)的影響要加以考慮。面積的影響溫度的影響有研硅股有研硅股24對(duì)策
14、strategies從初始材料形成到MOS結(jié)構(gòu)制備的基本流程初始材料封裝柵前清洗氧化物熱生長高溫致密化清洗金屬歐姆接觸單晶生長切片磨片腐蝕熱退火拋光清洗清洗氧化物沉積有研硅股有研硅股25對(duì)策COP的本質(zhì):空位的聚集體,是晶體生長過程中特定熱歷史條件下形成的原生缺陷。它在11501080范圍成核生長 有研硅股有研硅股26對(duì)策:v 完美晶體生長 (OPTIA) v 高溫退火 Ar or H2下常規(guī)爐退火 (HAI and IG NaNa wafers). RTP處理結(jié)合 COPs 的預(yù)控制v 外延薄膜沉積 (AEGIS, fLASH!, NaNa Epi).快速提拉摻氮拉晶COP缺陷的控制和消除缺
15、陷的控制和消除有研硅股有研硅股27對(duì)策:潔凈區(qū)和吸雜潔凈區(qū)和吸雜氧沉淀、層錯(cuò)等微缺陷PSG沉積、機(jī)械損傷、離子注入損傷、多晶硅、氮化物、激光損傷H、He注入產(chǎn)生的空腔有研硅股有研硅股28對(duì)策:外延外延有研硅股有研硅股29對(duì)策:真空封裝,縮短硅片存儲(chǔ)時(shí)間硅片在存儲(chǔ)6至18個(gè)月,硅片表面改變嚴(yán)格控制硅片包裝內(nèi)的濕度,表面有機(jī)物、離子氧化物厚度、金屬、及顆粒很穩(wěn)定。有研硅股有研硅股30對(duì)策:加強(qiáng)監(jiān)控加強(qiáng)監(jiān)控TXRF:檢測硅片表面金屬顆粒,ICP-MS:檢測硅片金屬顆粒和有機(jī)物激光散射顆粒儀 :檢測表面顆粒和COP,可以分辨0.12um的顆粒AFM :表面形貌,縱向分辨率可以達(dá)到0.11SPV:檢測硅片體內(nèi)Fe含量,ElementFeNiCuCrCaZnSClExitationWWWWWWWWLLD(E9 atom/cm23.12.01.65.0171.38954有研硅股有研硅股31對(duì)策
溫馨提示
- 1. 本站所有資源如無特殊說明,都需要本地電腦安裝OFFICE2007和PDF閱讀器。圖紙軟件為CAD,CAXA,PROE,UG,SolidWorks等.壓縮文件請(qǐng)下載最新的WinRAR軟件解壓。
- 2. 本站的文檔不包含任何第三方提供的附件圖紙等,如果需要附件,請(qǐng)聯(lián)系上傳者。文件的所有權(quán)益歸上傳用戶所有。
- 3. 本站RAR壓縮包中若帶圖紙,網(wǎng)頁內(nèi)容里面會(huì)有圖紙預(yù)覽,若沒有圖紙預(yù)覽就沒有圖紙。
- 4. 未經(jīng)權(quán)益所有人同意不得將文件中的內(nèi)容挪作商業(yè)或盈利用途。
- 5. 人人文庫網(wǎng)僅提供信息存儲(chǔ)空間,僅對(duì)用戶上傳內(nèi)容的表現(xiàn)方式做保護(hù)處理,對(duì)用戶上傳分享的文檔內(nèi)容本身不做任何修改或編輯,并不能對(duì)任何下載內(nèi)容負(fù)責(zé)。
- 6. 下載文件中如有侵權(quán)或不適當(dāng)內(nèi)容,請(qǐng)與我們聯(lián)系,我們立即糾正。
- 7. 本站不保證下載資源的準(zhǔn)確性、安全性和完整性, 同時(shí)也不承擔(dān)用戶因使用這些下載資源對(duì)自己和他人造成任何形式的傷害或損失。
最新文檔
- 護(hù)士護(hù)理業(yè)務(wù)查房:提升技能與優(yōu)化護(hù)理實(shí)踐
- 四川應(yīng)用技術(shù)職業(yè)學(xué)院《開發(fā)基礎(chǔ)》2023-2024學(xué)年第二學(xué)期期末試卷
- 江蘇省宜興市丁蜀區(qū)重點(diǎn)名校2024-2025學(xué)年初三下學(xué)期3月10日周中測數(shù)學(xué)試題試卷含解析
- 云南師范大學(xué)《產(chǎn)品U界面設(shè)計(jì)》2023-2024學(xué)年第二學(xué)期期末試卷
- 浙江省龍游第二高級(jí)中學(xué)2025屆高三一輪第五次階段性過關(guān)物理試題試卷含解析
- 浙江宇翔職業(yè)技術(shù)學(xué)院《金融綜合實(shí)訓(xùn)》2023-2024學(xué)年第二學(xué)期期末試卷
- 山西林業(yè)職業(yè)技術(shù)學(xué)院《冶金資源工程》2023-2024學(xué)年第二學(xué)期期末試卷
- 云南醫(yī)藥健康職業(yè)學(xué)院《寄生蟲學(xué)及檢驗(yàn)》2023-2024學(xué)年第二學(xué)期期末試卷
- 中國科學(xué)技術(shù)大學(xué)《運(yùn)動(dòng)技能學(xué)習(xí)與控制》2023-2024學(xué)年第二學(xué)期期末試卷
- 內(nèi)江師范學(xué)院《工程軟件應(yīng)用》2023-2024學(xué)年第二學(xué)期期末試卷
- 語音廳合同范例
- 《成分輸血指南》課件
- 【MOOC】新科學(xué)家英語:演講與寫作-哈爾濱工業(yè)大學(xué) 中國大學(xué)慕課MOOC答案
- 2024火力發(fā)電廠運(yùn)煤設(shè)備抑塵技術(shù)規(guī)范第4部分:輸送及轉(zhuǎn)運(yùn)設(shè)備抑塵
- 第一屆山東省職業(yè)能力大賽濟(jì)南市選拔賽制造團(tuán)隊(duì)挑戰(zhàn)賽項(xiàng)目技術(shù)工作文件(含樣題)
- 高中歷史選擇性必修第3冊試卷
- 老干工作業(yè)務(wù)培訓(xùn)
- GB/T 44744-2024糧食儲(chǔ)藏低溫儲(chǔ)糧技術(shù)規(guī)程
- 加工制作合同(儲(chǔ)存罐)
- 2023-2024學(xué)年廣東省深圳市寶安區(qū)八年級(jí)(下)期末英語試卷
- 雙碳全景系列培訓(xùn)第一章碳達(dá)峰、碳中和

評(píng)論
0/150
提交評(píng)論